بیضیسنجی
الیپسومتری (به انگلیسی: Ellipsometry) روشی نوری (اپتیکی) برای مطالعه ویژگیهای دیالکتریک لایه های نازک است.
در این روش با بررسی تغییرات قطبش نوز بازتابیده از نمونه، میتوان اطلاعاتی دربارهٔ لایههایی که نازکتر از طول موج نور (حتی به اندازه یک لایه اتمی) است، بدست آورد. این اطلاعات میتواند شامل ریختشناسی، ترکیب شیمیایی، زبری، ضخامت(عمق)، طبیعت کریستالی، غلظت آلایش، رسانایی الکتریکی و غیره باشد. نام الیپسومتری اشاره به این موضوع دارد که بیشتر حالتهای قطبش، بیضیگون هستند.
اساس کار
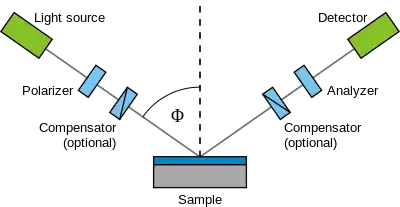
الیپسومتری تغییر در قطبش در اثر بازتاب یا عبور (نور) را اندازهگیری میکند و آن را با مدلی از پیش تعیین شده مقایسه میکند. غالبا الیپسومتری در حالت بازتاب انجام میگیرد. ویژگیهای یک ماده باعث میشود قطبش نور بازتابشیافته از آن تغییر کند. تابش الکترومغناطیسی با استفاده از یک منبع نوری انجام میشود و با یک قطبشگر، قطبیده میشود. پس از بازتابش، نور با قطبشگر دیگری که آنالیزور نام دارد برخورد میکند و به حسگر میرسد. میتوان از یک جبرانکننده در راه تابش و بازتابش استفاده کرد.
دادهها
زاویه تابش و بازتابش در این روش با هم برابرند. با تجزیه برداری نور، نوری که موازی صفحه تابش (صفحه عمود بر نمونه) است، P و نور عمود S نام دارد و و دامنه این دو موج نوری هستند و الیپسومتری با بکاربردن دو تا از چهار پارامتر استوکس ( و )، نسبت این دو دامنه را اندازهگیری میکند:
نسبت دامنه درست پس از بازتابش و جابجایی فاز است.
آنالیز دادهها
الیپسومتری روشی غیرمستقیم برای اندازهگیری ویژگیهاست. بدین معنا که از روی و نمیتوان یکراست خواص را بدست آورد مگر اینکه ماده همگن و همسانگرد باشد.
مزایا
الیپسومتری در مقایسه با روش اندازهگیری شدت بازتابش، مزایایی دارد:
- الیپسومتری دست کم دو پارامتر را برای یک طول موج طیف اندازهگیری میکند. با استفاده از الیپسومتری عمومی، میتوان تا 16 پارامتر را برای یک طول موج بدست آورد.
- از آنجا که الیپسومتری تغییرات را (و نه مقدار مطلق) اندازهگیری میکند، نیازی به پرتو یا نمونه مرجع ندارد و ناپایداریهای شدت نور از منبع یا جذب نور به وسیلهٔ هوا تأثیری بر آن ندارد.
- برای مطالعه مواد ناهمسانگرد این روش بسیار کارآمدتر از روش اندازهگیری شدت بازتابش است.
جستارهای وابسته
منابع
- R. M. A. Azzam and N. M. Bashara, Ellipsometry and Polarized Light, Elsevier Science Pub Co (1987) ISBN 0-444-87016-4
- A. Roeseler, Infrared Spectroscopic Ellipsometry, Akademie-Verlag, Berlin (1990), ISBN 3-05-500623-2
- H. G. Tompkins, A Users's Guide to Ellipsometry, Academic Press Inc, London (1993), ISBN 0-12-693950-0
- H. G. Tompkins and W. A. McGahan, Spectroscopic Ellipsometry and Reflectometry, John Wiley & Sons Inc (1999) ISBN 0-471-18172-2
- I. Ohlidal and D. Franta, Ellipsometry of Thin Film Systems, in Progress in Optics, vol. 41, ed. E. Wolf, Elsevier, Amsterdam, 2000, pp. 181–282
- M. Schubert, Infrared Ellipsometry on semiconductor layer structures: Phonons, Plasmons, and Polaritons, Series: Springer Tracts in Modern Physics, Vol. 209, Springer (2004), ISBN 3-540-23249-4
- H. G. Tompkins and E. A. Irene (Editors), Handbook of Ellipsometry William Andrews Publications, Norwich, NY (2005), ISBN 0-8155-1499-9
- H. Fujiwara, Spectroscopic Ellipsometry: Principles and Applications, John Wiley & Sons Inc (2007), ISBN 0-470-01608-6
