اچینگ یون فعال
اچینگ یون فعال یا RIE (به انگلیسی: Reactive Ion Etching) یکی از روش های اچینگ یا برش مواد در ساختارهای ریز و زیرمجموعه از روش های اچینگ پلاسما است. اچینگ یون فعال از جمله روش های اچینگ خشک است که مشخصه های بیشتری از اچینگ مرطوب دارد. این روش ترکیبی از روش های فیزیکی و شیمیایی شناخته می شود. در این روش از پلاسمای فعال کننده به صورت شیمیایی برای برش ویفر استفاده می شود. این روش در یک محفظه ی خلا با فشار پایین توسط یک میدان الکترومغناطیسی رخ می دهد. یون های پرانرژی پلاسما به صورت عمودی به سطح ویفر برخورد می کنند و باعث پدیده اچینگ می شوند. این روش از رزولوشن بالا و همچنین قابلیت کنترل مطلوبی برخوردار است که امکان برش مواد مختلفی از جمله نیمه هادی ها، عایق ها و بعضی فلزات را نیز فراهم می کند. یکی از برتری های این روش نسبت به روش های دیگر این است که می تواند به گونه ای طراحی شود که تا حدود زیادی غیرایزوتروپیک باشد که این بدین معناست که عمل اچینگ با دقت بالا و نرخ برش مطلوبی انجام می شود.
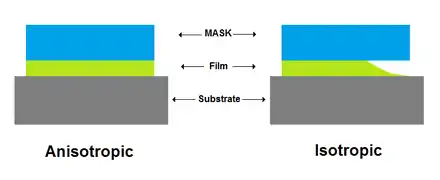

تجهیزات
سیستم RIE از یک محفظه ی استوانه ای شکل خلا، یک صفحه ویفر در قسمت پایین آن، دو الکترود موازی در قسمت بالایی و پایینی و دریچه ورود و خروج گاز به ترتیب در بالا و پایین محفظه تشکیل شده است. گازی که در این فرایند استفاده می شود بسته به نوع ویفر مورد نظر، متفاوت است. به عنوان مثال، گاز هگزا فلوراید گوگرد مناسب اچینگ ویفر سیلیکن است. فشار گاز محفظه معمولا بین چند میلی تور و چندصد میلی تور، با حفظ میزان ورود و خروج گاز ، حفظ می شود.
روش کار
پلاسما در سیستم توسط یک میدان الکترومغناطیس قوی RF ایجاد می شود. فرکانس این میدان معمولا 13.56 مگاهرتز است. میدان الکتریکی در حال نوسان مولکول های گاز را یونیزه می کند و به این شکل پلاسما شکل می گیرد. در هر چرخه میدان، الکترون ها به سمت پایین و بالا شتاب می گیرند و به الکترود بالای محفظه و گاهی به صفحه ویفر ضربه می زنند. یون هایی که به سظح ویفر می رسند اختلاف پتانسیل بین الکترود دو الکترود بالا و پایین محفظه را افزایش می دهند. این باعث می شود که یون های مثبت به سمت سطح ویفر شتاب بگیرند و واکنش شیمیایی دهند.
این فرایند بستگی زیادی به فشار محفظه، جریان گاز ورودی و خروجی و همچنین میدان الکترومغناطیسی دارد.
یکی از زیرشاخه های پیشرفته تر از این روش ، اچینگ یون فعال عمیق است که عمده تفاوت آن با این روش تفاوت دما است. در اچینگ یون فعال عمیق، دمای ویفر را پایین می آوند تا واکنش شیمیایی در سطح آن با سرعت پایین تری اتفاق بیفتد.
.svg.png.webp)

