لیتوگرافی به وسیله اشعه ماوراء بنفش
لیتوگرافی به وسیله اشعه ماوراء بنفش حد بالایی EUVL/Extreme Ultraviolet Lithography یکی از روشهای تصویرگیری پرتوافکنی است (شکل ۱و۲) که از اشعهای با طول موج بین ۱۳٫۴ تا nm ۱۳٫۵ استفاده میکند. اصول اولیه کارکرد EUVL شبیه به روش لیتوگرافی نوری است، با یک سیستم و ماسک که موج را تابانده و متمرکز میکند. لیتوگرافی پرتوافکنی نوری بیش از ۲۰ سال از اصلیترین راههای تولید قطعات نیمه هادی بودهاست. از مدتها قبل پیشبینی شده بود که لیتوگرافی پرتوافکنی نوری، ظرفیت تولید قطعات با هزینه اقتصادی مناسب و اندازه ویژگی (Feature size) کم همراه با تولید کنترل شده مدارهای مجتمع را دارد. پیچیدگی لیتوگرافی نوری، بهطور خاص مربوط به ساخت ماسک میشود. نقشه بینالمللی فناوری برای نیمه هادیها (ITRS/International Technology Roadmap for Semiconductors) پیشبینی میکند که احتمالا یک نمونه لیتوگرافی برای ساخت الگویی با نیم گام nm45 نیاز است. شکل ۳ نمایشی از نیم گام پیشبینی شده با زمان برای چهار مدل از ITRS. هرکدام از این مدلهای ITRS یک شتاب کاهشی در نیم گام را پیشبینی کردهاند. نامزد پیشرو و موفق در لیتوگرافی پرتوافکنی نوری، لیتوگرافی ماوراءبنفش حد بالایی (EUVL) و لیتوگرافی پرتوافکنی الکترونی (EPL/Electron Projection Lithography) هستند.


تقریبا تمام فناوریها از یکی از سه ذره انرژی دار، شامل پروتون، الکترون و یون جهت پرتوافکنی به ماده مقاوم به پرتو استفاده میکنند. تنها استثناء nanoimprint است، که از یک الگوی مادر برای برجسته کردن ماده مقاوم با استفاده از دما و فشار بدون هیچ گونه پرتوافکنی استفاده میکند. بعضی از فناوریها از یک ماسک برای در معرض قرار گرفتن قسمتی از یک الگو یا تمام الگو در یک گام پرتوافکنی استفاده میکنند.
همان طور که اشاره شد در لیتوگرافی پرتوافکنی از ماسک و از ماده مقاوم به پرتو استفاده میشود، که ماده مقاوم به پرتو مادهای پلیمری است و در مقابل پرتو تابیده شده به دو صورت از خود رفتار نشان میدهد. یا ماده پلیمری در اثر پرتو نگاری شبکه آن تقویت میشود که در این حالت ماده مقاوم را منفی(Negative) مینامیم؛ و اگر ماده پلیمری پس از تابش پرتو شبکه آن استحکام خود را از دست بدهد در این حالت ماده مقاوم به پرتو را مثبت (Positive) مینامیم (شکل۴(

در حالتی که ماده مقاوم منفی است پس از انجام لیتوگرافی الگوی ایجاد شده روی زیرلایه برعکس الگوی ماسک خواهد بود؛ و در حالتی که ماده مقاوم مثبت باشد پس از انجام لیتوگرافی الگوی ایجاد شده روی زیرلایه مشابه الگوی ماسک خواهد بود (شکلهای ۵ و ۶(
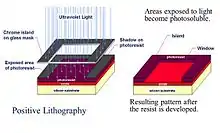

همان طور که از شکلهای ۵ و۶ مشخص است پس از تاباندن اشعه UV به ماده مقاوم، البته با گذر از ماسک، ماده مقاوم بسته به اینکه مثبت است یا منفی، استحکام آن به ترتیب کم یا زیاد میشود؛ لذا رفتار آنها در برابر محلول شیمیایی متفاوت خواهد بود، بدان معنا که برای ماده مقاوم مثبت، آن قسمتی که پرتو به آن تابیده شدهاست نسبت به آن قسمتی از آن که پرتو به آن تابیده نشدهاست از استحکام کمتری برخوردار بوده و لذا در اثر محلول شیمیایی خورده خواهد شد و در نتیجه الگوی ماسک روی زیرلایه به وجود خواهد آمد. در مورد ماده مقاوم منفی، همان طور که قبلاً اشاره شد نحوهٔ ایجاد الگو برعکس ماسک خواهد بود و اصول کار مشابه ماده مقاوم مثبت است.
تابش در طول موجهای EUV، به وسیله همه مواد به میزان زیادی جذب میشود، بنابراین، سطوحی از ماسک که باید نور را بازتاب کنند، با چندین لایه پوشانده میشوند. استفاده از امواج بازتاب شده میزان روزنه عددی را کاهش میدهد. روزنه عددی یک سیستم نوری، عدد بدون بعدی است که محدوده زاویهای را که سیستم میتواند نور دریافت کند یا خیر، مشخص میکند. روزنه عددی ابزار دریافتکننده EUVL، تقریباً در یک سیستم که چهار برابر کاهش یافتهاست، ۰٫۱ تا ۰٫۲۵ است. از آنجاییکه تابش EUV به میزان زیادی توسط مواد جذب میشود، سطحی از ماسک که بازتابکننده نور است، با چندین لایه پوشش داده میشود. این لایهها یک بازتاب تشدید شده براگ (Bragg) شکل میدهند که طول موجی نزدیک به طول موج اصلی تابانده شده دارد. ماسک EUVLشامل یک زیرلایه است که در اثر گرما به میزان کم و با فاکتور شش اینچ مربع منبسط میشود، که با چندین لایه از Mo/Si پوشانده میشود. ماسک پوشانده شده با چندین لایه، با یک لایه جذبکننده که الگوی IC مورد نظر را میتواند روی زیرلایه با بزرگنمایی چهار برابر منتقل کند، پوشش داده میشود. پوششهای چند لایه برای EUVL توزیعی از بازتابهای براگ دارند که به خاطر وجود لایههای دورهای است و به این خاطر این پوششها داده میشود که بازتاب را در یک طول موج خاص زیاد کند. بازتاب با زاویه برخورد و طول موج تغییر میکند. در طول موجهای EUVL (nm5-20)، تقریباً میتوان گفت همه مواد ضریب شکست نزدیک به یک دارند. هنک و همکارانش ضریب شکست را به صورت ترکیبی به شکل زیر ارئه کردند:
n ̅=1-δ+iβ
دو یا بیشتر از دو ماده بهطور نوعی انتخاب میشود تا تشکیل چند لایه دهند، و یک ماده انتخاب میشود بهطوریکه مقدار δ در طول موج عملکننده زیاد باشد و بازتاب را حداکثر نماید. این ماده باید همچنین اتلاف بازدهی کمی داشته باشد، کم شدن β باعث حداقل شدن جذب میشود. از آنجا که بازتاببرخورد نرمال برای همه مواد در طول موج هایEUV کم است، تعداد زیادی از لایهها آرایش پیدا میکنند و هرکدام به گونهای قرار میگیرد که فاز بازتاب آن با فاز مربوط به لایههای دیگر جمع شود؛ بنابراین، دورهای بودن لایهها به این خاطر است که تداخل امواج ناشی از بازتاب هر یک از لایهها که δ بزرگی دارند، را سازنده کند. ماده دیگر طوریکه δو βکمی داشته باشد، انتخاب میشود تا ضریب کنتراست بین لایهها را حداکثر و جذب را حداقل کند. در گروه موجی با طول موج حدود nm13.5، Mo و Ru هردو δ بزرگ و β نسبتا کوچکی دارد و سیسلیکون δ و β کمی دارد. مواد دیگری ممکن است جهت بهینه کردن بیشتر بازتاب اضافه شوند. بیشترین بازتاب در طول موج براگ اتفاق میافتد. اسپیلر، باربی و آتوود معادله براگ را برای اصلاح شکست ارائه کردهاند. معادله براگ برای یک چندلایه که از دو ماده یا بیشتر ساخته شده به صورت زیر است:
بهطوریکه
m درجه شکست موج است،d دوره لایهها، وd1 و d2 ضخامت دو لایه در هر دوره هستند. جدای از شباهت به لیتوگرافی نوری، انجام EUVL برای حجم زیاد تولید IC با مشکلات زیادی روبرو است:
- ماسک و اجزای نوری با چندین لایه پوشانده میشوند تا شرایط بازتاب بالا با طول موج nm13.5 فراهم شود.
- مسیر نوری و زیرلایه تحت اشعه قرار گرفته، باید در یک خلا mTorr1 به همراه گاز خنثی مثل Ar یا He قرار داشته باشند.
- یک منبع تابش به همراه خروجی با توان بالا باید استفاده شود. معمولاً لیزر یا تخلیه الکتریکی برای ایجاد یک پلاسمای گاز Xe که با طول موجهای بین ۱۰٫۵ تا nm14 منتشر میشود، استفاده میشود. اندازه و درخشندگی منبع نوری باید با طراحی سیستم متمرکزکننده بازتابی هماهنگ باشد.
- پلاسما در منبع باید طوری باشد که نه در جابجایی Xe و دستگاههای تخلیه بار مشکلی ایجاد کند و نه در جمع شدن امواج نوری نزدیک هم.
- پوشش چند لایهای دورهای روی لوازم نوری و ماسک باید دقت بالا و میزان یکنواختی متوسطی در حدود ۰٫۱٪ داشته باشد. دوره باید دقیق باشد تا امواج عبوری را که در هم منعکس شدهاند، با هم هماهنگ کند. فصل مشترک بین لایهها باید کاملاً از هم جدا و تیز باشد تا انعکاس را حداکثر نماید. زیرلایه نوری نیز باید کاملاً صاف باشد.
- پوششهای چندلایه باید در محیط خلا و در مدت زمان زیادی که در معرض اشعه قرار دارند، اکسید نشده و با لایههای نازک اکسیدی نیز پوشیده نشوند.
- پوششهای چندلایه روی ماسک باید با نقایص کمی همراه باشند.
- از آنجا که پوشش چندلایهای حدود ۴۰٪ پرتوهای برخوردی را جذب میکند، قسمتهای نوری و ماسک باید بر روی زیرلایهای با انبساط گرمایی کم ساخته شود. این زیرلایهها همچنین باید در حین پرتو نگاری سرد شوند.
- ماده مقاوم باید ضخامتی کمتر از nm150داشته باشد تا اشعه EUV به درستی در اعماق آن تأثیرگذار باشد.
اگر از این مشکلات چشم پوشی کنیم، EUVL پتانسیل زیادی برای توسعه وضوح لیتوگرافی تا نیم گام nm22 و حتی کمتر از این مقدار، دارد. اگرچه هنوز مشکلات زیادی در فناوری باقی ماندهاست، ولی واضح است که EUV به عنوان روش اصلی ایجاد الگوهای ادواتی با نیم گام nm45 و کمتر شناخته میشود (شکل۷)
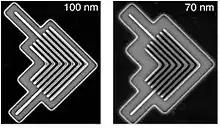
لینکهای مفید
جستارهای وابسته
- لیتوگرافی نوری
- استریولیتوگرافی
- روشهای ساخت ریزساختار از پلاستیک
- آزمایشگاه روی تراشه